CMPスラリー展開事例「RDLインターポーザ用」「樹脂/メタルのハイブリッドボンディング用」
↻更新日:

成長市場のCMPスラリー
AIチップやスマートフォン等の多くのデバイスの需要により、現代の半導体技術は、さらなる小型化や高性能化が求められています。
RDL(再配線層)技術を駆使したインターポーザは、高密度配線と優れた電気的接続性を提供し、多様なチップ間で効率的な通信が可能です。
また、新しい接合技術である、ハイブリッドボンディング技術により異なる材料や構造を効率的に結びつけることができます。
これらの技術によって、新しい応用分野への展開が進んでいます。
この技術革新はCMPスラリーによる表面平坦化プロセスと組み合わせることで、さらなる精度向上が図られています。
AIプロセッサや5G通信モジュールなど次世代テクノロジーでは、このような高度なパッケージングソリューションが求められており、市場からの期待も大きくなっています。
本記事では、CMPスラリー展開事例として「RDLインターポーザ用」「樹脂/メタルのハイブリッドボンディング用」の2種類のCMPスラリーをご紹介いたします。
※CMPスラリーとは?
※CMPスラリー関するよくある質問(FAQ)
RDL(再配線層)技術を駆使したインターポーザは、高密度配線と優れた電気的接続性を提供し、多様なチップ間で効率的な通信が可能です。
また、新しい接合技術である、ハイブリッドボンディング技術により異なる材料や構造を効率的に結びつけることができます。
これらの技術によって、新しい応用分野への展開が進んでいます。
この技術革新はCMPスラリーによる表面平坦化プロセスと組み合わせることで、さらなる精度向上が図られています。
AIプロセッサや5G通信モジュールなど次世代テクノロジーでは、このような高度なパッケージングソリューションが求められており、市場からの期待も大きくなっています。
本記事では、CMPスラリー展開事例として「RDLインターポーザ用」「樹脂/メタルのハイブリッドボンディング用」の2種類のCMPスラリーをご紹介いたします。
※CMPスラリーとは?
※CMPスラリー関するよくある質問(FAQ)
RDLとは
RDL(Redistribution Layer)とは、半導体チップ上で電気的接続を最適化し、高密度な回路設計を可能にする技術です。この技術は先端パッケージングプロセスで不可欠となっています。小型化や高性能化が求められる現代のデバイス製造において、その価値がますます高まっています。
インターポーザとは
インターポーザ(interposer)とは、半導体チップや電子部品を接続するための中間基板です。異なるサイズや形状の部品を効率的に接続するために使用され、電子機器の小型化や高性能化に不可欠な要素となっています。
ハイブリッドボンディングとは
ハイブリッドボンディング技術とは、半導体製造における革新的な接合方法です。
この技術は異なる材料を高精度で結合することが可能であり、高性能デバイスの実現に寄与しています。
例えば、CMPスラリーによって表面平坦化された基板上に樹脂層を形成し、その後メタル配線と組み合わせることで、高密度かつ信頼性の高い回路構築が可能となります。
また、このプロセスでは従来よりも低温での処理が行えるため、熱的ストレスを軽減しながら優れた電気的特性を維持できます。
これらの利点から、絶縁膜にPIを使用するものは次世代プロセスとして幅広い分野での利用が期待されています。
この技術は異なる材料を高精度で結合することが可能であり、高性能デバイスの実現に寄与しています。
例えば、CMPスラリーによって表面平坦化された基板上に樹脂層を形成し、その後メタル配線と組み合わせることで、高密度かつ信頼性の高い回路構築が可能となります。
また、このプロセスでは従来よりも低温での処理が行えるため、熱的ストレスを軽減しながら優れた電気的特性を維持できます。
これらの利点から、絶縁膜にPIを使用するものは次世代プロセスとして幅広い分野での利用が期待されています。
概要
樹脂基板上に、配線を再分配するための層(Redistribution Layer)を形成し、その上にチップレット化されたダイを同一平面状に並べて相互接続するインターポーザ技術です(図1)。
このRDLインターポーザを研磨する場合、第一段階として、Cu用高速研磨スラリーを用いて、まずCuを除去し、続いて、第二段階として、バリアメタル(BM)膜を除去します(図2)。
このRDLインターポーザを研磨する場合、第一段階として、Cu用高速研磨スラリーを用いて、まずCuを除去し、続いて、第二段階として、バリアメタル(BM)膜を除去します(図2)。
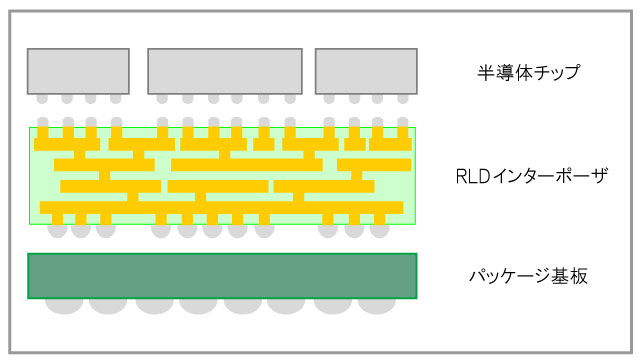
【 図1 : RDLインターポーザの構造 】

【 図2 : RDLインターポーザにおける配線形成プロセス 】
樹脂/メタルのハイブリッドボンディング用CMPスラリー
概要
デバイスメーカーでは、ポリイミド(PI)を削ると同時に、PI中に埋まっているCu(銅)プラグの表面が現われたところで、研磨を終了したいというニーズがあります。
なおかつ、1分間でミクロンオーダーの高速研磨が必要で、表面粗さについても一定のレベルを確保することが必要です。
こうした要望に対して、TOPPANインフォメディアでは、研磨テストを重ねた結果、適した粒子種・粒子径・pH・反応促進剤をみいだすことができ、小径研磨砥粒を使用したCMPスラリーを用いることで、PI膜と銅配線の高速除去による同時研磨が可能となりました。研磨後の表面粗さは、Ra 1.2 nm以下と良好です(図3)。
なおかつ、1分間でミクロンオーダーの高速研磨が必要で、表面粗さについても一定のレベルを確保することが必要です。
こうした要望に対して、TOPPANインフォメディアでは、研磨テストを重ねた結果、適した粒子種・粒子径・pH・反応促進剤をみいだすことができ、小径研磨砥粒を使用したCMPスラリーを用いることで、PI膜と銅配線の高速除去による同時研磨が可能となりました。研磨後の表面粗さは、Ra 1.2 nm以下と良好です(図3)。

【 図3 : 樹脂╱メタルのハイブリッドボンディングのプロセス 】
CMPスラリー製品ラインアップ
上記の他に、TOPPANインフォメディアでは様々な種類のCMPスラリーを扱っております。
当社は、単一材料を研磨するだけでなく、異種材料を高選択または低選択にて同時に研磨することを得意としています。
| 用途 | 製品名 | 対象研摩物 | 説明 |
|---|---|---|---|
| 銅デバイス、立体配線接続用 | TPC | Cu | 半導体配線Cu研磨用シリカスラリー |
| 銅デバイス、立体配線接続用 | MKT | Ta | 半導体配線バリア膜研磨用シリカスラリー |
| 銅デバイス、立体配線接続用 | MKW | W | Wコンタクトプラ府用シリカスラリー |
| TSV用 |
SE-High <開発品> |
厚膜Cu |
厚膜Cu研磨用シリカスラリー ミクロンオーダーのCu高速除去 |
| TSV用 |
Si-07 <開発品> |
Si | Si基板およびTSV裏面研磨用スラリー |
| 樹脂研磨 |
CME <開発品> |
フィラー入り樹脂膜 | ビルドアップ基板用樹脂研磨スラリー |
| 樹脂研磨 |
PI-01 <開発品> |
PI, Cu | ポリイミド膜およびCu研磨用スラリー |
| その他 |
CMS <開発品> |
SiO2 | 半導体酸化膜研磨用セリアスラリー |
| その他 | DS-01 |
磁気ヘッド (AlTiC) |
油系ダイヤモンドスラリー 再分散性良好、高速研磨かつ低スクラッチを達成 研磨後の被研磨物への被着物を低減 |

あわせて読みたい
おすすめコンテンツはこちら






